Слайд 11. Основные сведения по физике полупроводников.
Лекция №1.
2. Электронно-дырочный переход
и его свойства.
3. Перспективы применения новых полупроводни-
ковых материалов.
Электроника и схемотехника
Тема:
Полупроводники. P-n переход и его свойства.
Слайд 21. Основные сведения по физике полупроводников.
В твердых телах
происходит расщепление энергетических уровней электронов, на большое количество почти сливающихся
подуровней, образующих энергетические зоны.
Разрешенная зона, в которой при температуре абсолютного нуля все энергетические зоны заняты электронами, называется валентной.
Разрешенная зона, в которой при температуре абсолютного нуля электроны отсутствуют, называется зоной проводимости. Между валентной зоной и зоной проводимости расположена запрещенная зона.
Расщепление энергетических уровней электронов в твердых телах
1.1 Проводники, полупроводники, диэлектрики.
Слайд 3 Ширина запрещенной зоны является основным параметром, характеризующим свойства
твердого тела. Вещества, у которых ширина запрещенной энергетической зоны 0,01≤ΔW≤3
эВ, относятся к полупроводникам, а при ΔW>3 эВ – к диэлектрикам. У металлов (проводников) запрещенная зона отсутствует. Например, у полупроводников: германий Ge(ΔW=0,67 эВ), кремний Si(ΔW=1,12 эВ), арсенид галия GaAs(ΔW=1,43 эВ), карбид кремния SiC(ΔW=2,4-3,4 эВ).
Зонные энергетические диаграммы твердых веществ
Для перехода электрона из низшей энергетической зоны в высшую требуется затратить энергию, равную ширине запрещенной зоны. При ширине запрещенной зоны в несколько электрон-вольт внешнее электрическое поле практически не может перевести электрон из валентной зоны в зону проводимости, так как энергия, приобретаемая электроном, движущимся ускоренно на длине свободного пробега, недостаточна для преодоления запрещенной зоны. Длиной свободного пробега является расстояние, проходимое электроном между двумя соударениями с атомами кристаллической решетки.
Зонные энергетические диаграммы различных твердых веществ: а – проводник; б – полупроводник; в – диэлектрик
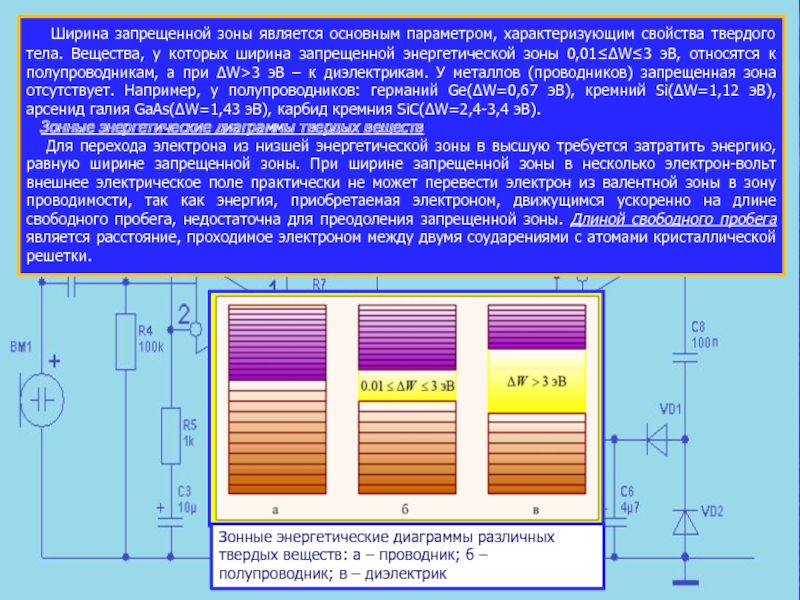
Слайд 4 Если веществу сообщить достаточное количество энергии, то электроны,
приобретая дополнительное количество энергии, могут преодолеть ширину запрещенной зоны и
перейти в зону проводимости.
Полупроводники. Терминология и основные понятия.
Полупроводники, или полупроводниковые соединения, бывают собственными и примесными.
Собственные полупроводники - это полупроводники, в которых нет примесей (доноров и акцепторов). Собственная концентрация (ni) - концентрация носителей заряда в собственном полупроводнике (электронов в зоне проводимости n и дырок в валентной зоне p, причем n = p = ni). При Т = 0 в собственном полупроводнике свободные носители отсутствуют (n = p = 0). При Т > 0 часть электронов забрасывается из валентной зоны в зону проводимости. Эти электроны и дырки могут свободно перемещаться по энергетическим зонам. Дырка - это способ описания коллективного движения большого числа электронов (примерно 1023 см-3) в не полностью заполненной валентной зоне. Электрон - это частица, дырка - это квазичастица. Электрон можно инжектировать из полупроводника или металла наружу (например, с помощью фотоэффекта), дырка же может существовать только внутри полупроводника.
Легирование - введение примеси в полупроводник, в этом случае полупроводник называется примесным. Если в полупроводник, состоящий из элементов 4 группы (например, кремний или германий), ввести в качестве примеси элемент 5 группы, то получим донорный полупроводник (у него будет электронный тип проводимости), или полупроводник n - типа. Если же ввести в качестве примеси элемент 3 группы, то получится акцепторный полупроводник, обладающий дырочной проводимостью (р - тип).
В кристалле кремния (Si) атомы располагаются в узлах кристаллической решетки, а электроны наружной электронной оболочки образуют устойчивые ковалентные связи, когда каждая пара валентных электронов принадлежит одновременно двум соседним атомам и образует связывающую

Слайд 5эти атомы силу. Так как у элементов IV группы на
наружной электронной оболочке располагаются по четыре валентных электрона, то в
идеальном кристалле полупроводника все ковалентные связи заполнены, и все электроны прочно связаны со своими атомами.
При температуре абсолютного нуля (T=0° K) все энергетические состояния внутренних зон и валентная зона занята электронами полностью, а зона проводимости совершенно пуста. Поэтому в этих условиях кристалл полупроводника является практически диэлектриком.
Структура связей атома кремния в кристаллической решетке.
Слайд 6 При температуре (T>0° K) в результате увеличения амплитуды
тепловых колебаний атомов в узлах кристаллической решетки дополнительной энергии, поглощенной
каким-либо электроном, может оказаться достаточно для разрыва ковалентной связи и перехода в зону проводимости, где электрон становится свободным носителем электрического заряда
Генерация пары свободных носителей заряда «электрон–дырка»
Электроны хаотически движутся внутри кристаллической решетки и представляют собой так называемый электронный газ. Электроны при своем движении сталкиваются с колеблющимися в узлах кристаллической решетки атомами, а в промежутках между столкновениями они движутся прямолинейно и равномерно.
Одновременно с этим у того атома полупроводника, от которого отделился электрон, возникает незаполненный энергетический уровень в валентной зоне, называемый дыркой.
Таким образом, в идеальном кристалле полупроводника при нагревании могут образовываться пары носителей электрических зарядов «электрон – дырка», которые обусловливают появление собствен-
Слайд 7ной электрической проводимости полупроводника.
Процесс образования пар «электрон
– дырка» называют генерацией свободных носителей заряда.
После своего
образования пары «электрон – дырка» существуют в течение некоторого времени, называемого временем жизни носителей электрического заряда.
В течение этого промежутка времени носители участвуют в тепловом движении, взаимодействуют с электрическими и магнитными полями, как единичные электрические заряды, перемещаются под действием градиента концентрации, а затем рекомбинируют, т. е. электрон восстанавливает ковалентную связь.
При рекомбинации электрона и дырки происходит высвобождение энергии, в зависимости от того, как расходуется эта энергия, рекомбинацию можно разделить на два вида: излучательную и безызлучательную.
Излучательной является рекомбинация, при которой энергия, освобождающаяся при переходе электрона на более низкий энергетический уровень, излучается в виде кванта света – фотона.
При безызлучательной рекомбинации избыточная энергия передается кристаллической решетке полупроводника, т. е. избыточная энергия идет на образование фононов – квантов тепловой энергии.
Следует отметить, что генерация пар носителей заряда «электрон – дырка» и появление собственной электропроводности полупроводника может происходить не только под действием тепловой энергии, но и при любом другом способе энергетического воздействия на полупроводник: квантами лучистой энергии, ионизирующим излучением и т. д.
1.3 Распределение электронов по энергетическим уровням.
При неизменном температурном состоянии полупроводника распределение электронов по энергетическим уровням подчиняется квантовой статистике Ферми – Дирака. С ее помощью можно определить концентрацию электронов в зоне проводимости, дырок в валентной зоне и определить

Слайд 9Распределение электронов по энергетическим уровням для чистого полупроводника
1.4 Примесная электропроводность
полупроводников.
Электропроводность полупроводника может обусловливаться не только генерацией пар
носителей «электрон – дырка» вследствие какого-либо энергетического воздействия, но и введением в структуру полупроводника определенных примесей. Примеси могут быть донорного и акцепторного типа.
Слайд 10 Легирование - процесс введения примесей в полупроводник. Для
легирования используется 3-х валентные бор, алюминий, индий, галлий и 5-и
валентные сурьма, мышьяк, фосфор. Чем выше степень легирования, тем выше будет располагаться уровень Ферми у n - полупроводников.
Полупроводники n - типа, у которых уровень Ферми располагается в зоне проводимости, называются вырожденными полупроводниками.
Уровень Ферми у полупроводников p -типа располагается ниже середины запрещённой зоны.
Чем выше степень легирования, тем ниже уровень Ферми. Тогда у вырожденных полупроводников p -типа WF – в валентной зоне.
1.4.1 Донорные примеси .
Структура полупроводника с донорными примесями.
Слайд 11 При введении в 4-валентный полупроводник примесных 5-валентных атомов,
например, сурьмы (Sb) атомы примесей замещают основные атомы в узлах
кристаллической решетки. Четыре электрона атома примеси вступают в связь с четырьмя валентными электронами соседних атомов основного полупроводника. Пятый валентный электрон слабо связан со своим атомом и при сообщении ему незначительной энергии, называемой энергией активации, отрывается от атома и становится свободным. Примеси, увеличивающие число свободных электронов, называют донорными или просто донорами. Малая энергия активации примесей (0,01.. .0,2 эВ) уже при комнатной температуре приводит к полной ионизации 5-валентных атомов примесей и появлению свободных электронов. Поскольку в этом случае появление свободных электронов не сопровождается одновременным увеличением количества дырок (ионизированные 5-валентные атомы, хотя и являются носителями положительного заряда, не могут свободно перемещаться по кристаллу или обмениваться валентными электронами с соседними атомами основного вещества), в таком полупроводнике концентрация электронов оказывается значительно больше концентрации дырок (дырки образуются только в результате разрыва ковалентных связей между атомами основного вещества). Полупроводники, в которых концентрация свободных электронов превышает концентрацию дырок, называются полупроводниками с электронной электропроводностью или полупроводниками n -типа (негативная, отрицательная проводимость).
Подвижные носители заряда, преобладающие в полупроводнике, называют основными. Соответственно те носители заряда, которые находятся в меньшем количестве, называются неосновными для данного типа полупроводника В полупроводнике n -типа основными носителями заряда являются электроны, а неосновными - дырки.

Слайд 12Зонная диаграмма(а) и распределение электронов по энергетиче-ским уровням(б) полупроводника с
донорными примесями.
1.4.2 Акцепторные примеси .
Слайд 13Структура полупроводника с акцепторными примесями
Если в кристалле 4-валентного
элемента часть атомов замещена атомами 3-валентного элемента, например, индия (In),
то для образования четырех ковалентных связей у примесного атома не хватает одного электрона. Этот электрон может быть получен от атома основного элемента полупроводника за счет разрыва ковалентной связи. Разрыв связи приводит к появлению дырки. Примеси, захватывающие валентные электроны, называют акцепторными или акцепторами. Ввиду малого значения энергии активации акцепторов уже при комнатной температуре многие валентные электроны переходят на уровни акцепторов. Эти электроны, превращая примесные атомы в отрицательные ионы, теряют способность перемещаться по кристаллической решетке, а образовавшиеся при этом дырки могут участвовать в создании электрического тока. За счет ионизации атомов исходного материала часть валентных электронов становится свободной. Однако свободных электронов значительно меньше, чем дырок. Поэтому дырки в таких полупроводниках являются основными, а электроны - неосновными подвижными носителями заряда. Такие полупроводники носят название полупроводников с дырочной электропроводностью или полупроводников р -типа(позитивный, положительный тип проводимости).

Слайд 14Зонная диаграмма (а) и распределение электронов по энер-гетическим уровням (б)
полупроводника с акцепторными примесями
Вероятность захвата электрона и перехода
его в валентную зону возрастает в полупроводниках p -типа, поэтому уровень Ферми здесь смещается вниз, к границе валентной зоны (б).
Слайд 151.5 Процессы переноса зарядов в полупроводниках.
В полупроводниках процесс
переноса зарядов может наблюдаться при наличии электронов в зоне проводимости
и при неполном заполнении электронами валентной зоны. При выполнении данных условий и при отсутствии градиента температуры перенос носителей зарядов возможен либо под действием электрического поля, либо под действием градиента концентрации носителей заряда.
1.5.1 Дрейфовый ток.
В полупроводниках свободные электроны и дырки находятся в состоянии хаотического движения. Поэтому, если выбрать произвольное сечение внутри объема полупроводника и подсчитать число носителей зарядов, проходящих через это сечение за единицу времени слева направо и справа налево, значения этих чисел окажутся одинаковыми. Это означает, что электрический ток в данном объеме полупроводника отсутствует.
При помещении полупроводника в электрическое поле на хаотическое движение носителей зарядов накладывается составляющая направленного движения. Направленное движение носителей зарядов в электрическом поле обусловливает появление тока, называемого дрейфовым. Из-за столкновения носителей зарядов с атомами кристаллической решетки их движение в направлении действия электрического поля будет прерывистым. Такое движение может быть охарактеризовано средней скоростью движения носителей зарядов в направлении действия электрического поля. Средняя скорость движения носителей зарядов в поле единичной напряженности называется подвижностью.
Подвижность носителей зарядов зависит от механизма их рассеяния в кристаллической решетке. Подвижности электронов (μn) и дырок (μp) в полупроводнике имеют различное значение (μn > μp) и определяются температурой и концентрацией примесей. Увеличение температуры приводит к уменьшению подвижности, что зависит от числа столкновений носителей зарядов в единицу времени.
Зная подвижность и концентрацию носителей зарядов в полупроводнике, можно легко определить его удельную электропроводность (ϭ):

Слайд 16Ϭ= Ϭn+ Ϭp=q(nμn+pμp), где Ϭn, Ϭp:-электронная и дырочная составляющие электропроводности,
q - элементарный отрицательный заряд, n и p - концентрации,
соответственно, электронов и дырок.
Для полупроводника с собственной электропроводностью:
n=p=ni , Ϭi=qni(μn+μp) .
Для полупроводника n –типа: Ϭ≈ Ϭn=qnn0μn.
Для полупроводника p –типа: Ϭ≈ Ϭp=qpp0μp,
где nn0 и pp0 - концентрации электронов и дырок в полупроводнике в состоянии теплового равновесия.
В области высоких температур концентрация свободных носителей в полупроводнике значительно возрастает из-за разрыва ковалентных связей и, несмотря на уменьшение их подвижности, электропроводность полупроводника увеличивается по экспоненциальному закону.
1.5.2 Диффузионный ток.
Кроме теплового возбуждения, приводящего к возникновению равновесной концентрации зарядов, равномерно распределенных по объему полупроводника, обогащение полупроводника электронами и дырками может осуществляться различными внешними воздействиями (освещением полупроводника, облучением потоком заряженных частиц, введением носителей заряда через контакт и т.д.). В этом случае энергия возбудителя передается непосредственно носителям заряда, а тепловая энергия кристаллической решетки остается практически постоянной. Следовательно, избыточные носители заряда не находятся в тепловом равновесии с решеткой и поэтому называются неравновесными. В отличие от равновесных носителей, они могут неравномерно распределяться по объему полупроводника.
После прекращения действия возбудителя за счет рекомбинации электронов и дырок концентрация избыточных носителей быстро убывает и достигает равновесного значения. Носители зарядов рекомбинируют в объеме полупроводника и на его поверхности. Неравномерное распределение неравновесных носителей зарядов сопровождается их диффузией в сторону меньшей концентрации. Это движение носителей зарядов обусловливает прохождение электрического тока, называемого диффузионным.

Слайд 172.Электронно-дырочный переход и его свойства.
Принцип действия большинства полупроводниковых
приборов основан на физических явлениях, происходящих в области контакта твердых
тел. При этом преимущественно используются контакты: полупроводник-полупроводник, металл-полупроводник, металл-диэлектрик-полупроводник. Если переход создается между полупроводниками n -типа и p -типа, то его называют электронно-дырочным или p - n -переходом.
Различают гомогенные и гетерогенные переходы:
Гомогенный – этот переход между полупроводниками с одинаковой шириной запрещённой зоны.
Гетерогенный – это переход между полупроводниками с разной шириной запрещённой зоны.
Концентрации основных носителей заряда в областях p и n могут быть равными или существенно отличаться. p - n -переход, у которого концентрации дырок и электронов практически равны , называют симметричным. Если концентрации основных носителей заряда различны ( или ) и отличаются в 100...1000 раз, то такие переходы называют несимметричными.
Начальный момент образования p-n-перехода
Слайд 18 Свободные носители электрических зарядов под действием градиента концентрации
начинают перемещаться из мест с большой концентрацией в места с
меньшей концентрацией. Так дырки будут диффундировать из области p в область n , а электроны – наоборот, из области n в область p. Это направленное навстречу друг другу перемещение электрических зарядов образует диффузионный ток p - n –перехода.
Вблизи границы раздела образуется слой пространственных зарядов, разделенных узким промежутком δ. Между этими зарядами возникает электрическое поле, которое называют полем потенциального барьера, а разность потенциалов на границе раздела двух зон, обусловливающих это поле, называют контактной разностью потенциалов Δφk.
p-n-переход при отсутствии внешнего напряжения
Слайд 19 Это электрическое поле начинает действовать на подвижные носители
электрических зарядов. Так дырки в области p – основные носители,
попадая в зону действия этого поля, испытывают со стороны него тормозящее, отталкивающее действие и, перемещаясь вдоль силовых линий этого поля, будут вытолкнуты вглубь области p. Аналогично, электроны из области n, попадая в зону действия поля потенциального барьера, будут вытолкнуты им вглубь области n. Таким образом, в узкой области , где действует поле потенциального барьера, образуется слой, где практически отсутствуют свободные носители электрических зарядов и вследствие этого обладающий высоким сопротивлением. Это так называемый запирающий слой.
Неосновные носители – дырки и электроны, под действием поля потенциального барьера будут переброшены в области, где они будут уже основными носителями. Движение неосновных носителей через p-n-переход под действием электрического поля потенциального барьера обусловливает составляющую дрейфового тока.
При отсутствии внешнего электрического поля устанавливается динамическое равновесие между потоками основных и неосновных носителей электрических зарядов, то есть между диффузионной и дрейфовой составляющими тока p-n-перехода, поскольку эти составляющие направлены навстречу друг другу.
При отсутствии внешнего электрического поля и при условии динамического равновесия в кристалле полупроводника устанавливается единый уровень Ферми для обеих областей проводимости.
Поскольку в полупроводниках p -типа уровень Ферми смещается к потолку валентной зоны, а в полупроводниках n -типа – ко дну зоны проводимости , то на ширине p-n-перехода диаграмма энергетических зон искривляется и образуется потенциальный барьер:
где: ΔW – энергетический барьер, который необходимо преодолеть электрону в области n, чтобы он мог перейти в область p, или аналогично для дырки в области p, чтобы она могла перейти в область n.
Высота потенциального барьера зависит от концентрации примесей, так как при ее изменении изменяется уровень Ферми, смещаясь от середины запрещенной зоны к верхней или нижней ее границе.

Слайд 20Зонная диаграмма p-n-перехода, иллюстрирующая баланс токов в равновесном состоянии
2.1 Вентильные
свойства p-n-перехода .
p-n-переход обладает свойством изменять свое электрическое
сопротивление в зависимости от направления протекающего через него тока. Это свойство называется вентильным.
2.1.1 Прямое включение p-n-перехода .
Рассмотрим p-n -переход, к которому подключен внешний источник напряжения с полярностью – «+» к области p -типа, «–» к области n-типа. Такое подключение называют прямым включением p-n
Слайд 21
Это приведет, в свою очередь, к снижению высоты
потенциального барьера и увеличению количества основных носителей, диффундирующих через границу
раздела в соседнюю область, ко-
-перехода (или прямым смещением p-n-перехода). Тогда напряженность электрического поля внешнего источника Евн будет направлена навстречу напряженности поля потенциального барьера Е и, следовательно, приведет к снижению результирующей напряженности Ерез.
Прямое смещение p-n -перехода
Слайд 22торые образуют так называемый прямой ток p-n -перехода. При этом
вследствие уменьшения тормозящего, отталкивающего действия поля потенциального барьера на основные
носители, ширина запирающего слоя уменьшается и соответственно уменьшается его сопротивление. По мере увеличения внешнего напряжения прямой ток p-n-перехода возрастает. Основные носители после перехода границы раздела становятся неосновными в противоположной области полупроводника и, углубившись в нее, рекомбинируют с основными носителями этой области, но, пока подключен внешний источник, ток через переход поддерживается непрерывным поступлением электронов из внешней цепи в n - область и уходом их из p – области во внешнюю цепь, благодаря чему восстанавливается концентрация дырок в p -области.
Введение носителей заряда через p-n – переход при понижении высоты потенциального барьера в область полупроводника, где эти носители являются неосновными, называют инжекцией носителей заряда.
При протекании прямого тока из дырочной области р в электронную область n инжектируются дырки, а из электронной области, в дырочную – электроны.
Зонная диаграмма прямого смещения p-n -перехода, иллюстрирующая дисбаланс токов
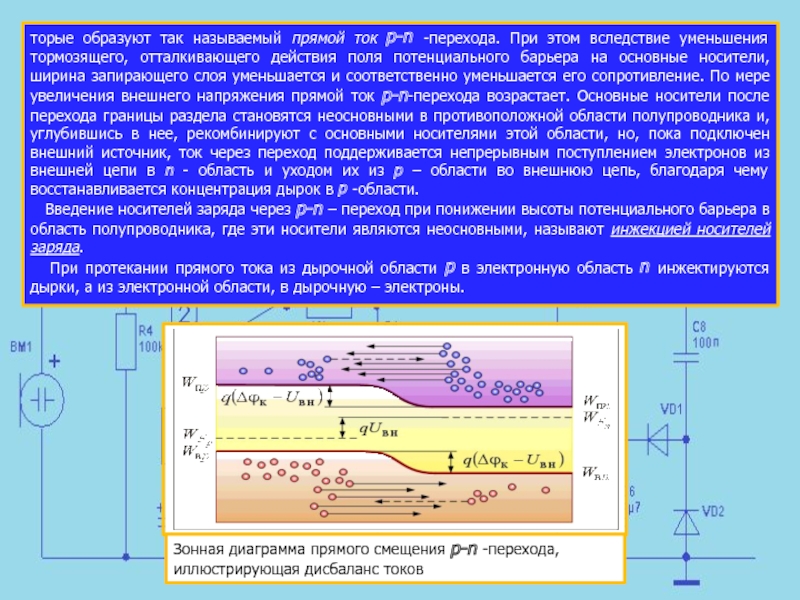
Слайд 232.1.2 Обратное включение p-n-перехода .
Если к р-n-переходу подключить
внешний источник с противоположной полярностью «–» к области p -типа,
«+» к области n –типа, то такое подключение называют обратным включением p-n –перехода (или обратным смещением p-n-перехода). В данном случае напряженность электрического поля Евн этого источника будет направлена в ту же сторону, что и напряженность электрического поля Е потенциального барьера; высота потенциального барьера возрастает, а ток диффузии основных носителей практически становится равным нулю. Из-за усиления тормозящего,
Обратное смещение p-n-перехода
Слайд 24отталкивающего действия суммарного электрического поля на основные носители заряда ширина
запирающего слоя увеличивается , а его сопротивление резко возрастает. Теперь
через р-n –переход будет протекать очень маленький ток, обусловленный суммарным электрическим полем на границе раздела, неосновных носителей, возникающих под действием различных ионизирующих факторов, в основном теплового характера. Процесс переброса неосновных носителей заряда называется экстракцией. Этот ток имеет дрейфовую природу и называется обратным током р-n-перехода.
Зонная диаграмма обратного смещения p-n-перехода, иллюстрирующая дисбаланс токов
Слайд 252.2 Вольт-амперная характеристика р-n-перехода.
Слайд 26 Однако приведенное уравнение весьма приблизительно совпадает с реальными
вольт - амперными характеристиками, так как не учитывает целого ряда
физических процессов, происходящих в полупроводниках. К таким процессам относятся: генерация и рекомбинация носителей в запирающем слое, поверхностные утечки тока, падение напряжения на сопротивлении нейтральных облаcтей, явления теплового, лавинного и туннельного пробоев.
При прямом напряжении внешнего источника экспоненциальный член в выражении быстро возрастает, что приводит к быстрому росту прямого тока, который, в основном определяется диффузионной составляющей.
При обратном напряжении внешнего источника экспоненциальный член много меньше единицы и ток p-n -перехода практически равен обратному току I0, определяемому, в основном, дрейфовой составляющей. Первый квадрант соответствует участку прямой ветви вольт-амперной характеристики, а третий квадрант – обратной ветви. При увеличении прямого напряжения ток p-n -перехода в прямом направлении вначале возрастает относительно медленно, а затем начинается участок быстрого нарастания прямого тока, что приводит к дополнительному нагреванию полупроводниковой структуры. Если количество выделяемого при этом тепла будет превышать количество тепла, отводимого от полупроводникового кристалла либо естественным путем, либо с помощью специальных устройств охлаждения, то могут произойти в полупроводниковой структуре необратимые изменения вплоть до разрушения кристаллической решетки. Поэтому прямой ток p-n -перехода необходимо ограничивать на безопасном уровне, исключающем перегрев полупроводниковой структуры. Для этого необходимо использовать ограничительное сопротивление последовательно подключенное с p-n -переходом.
При увеличении обратного напряжения, приложенного к p-n -переходу обратный ток изменяется незначительно, так как дрейфовая составляющая тока, являющаяся превалирующей при обратном включении, зависит в основном от температуры кристалла, а увеличение обратного напряжения приводит лишь к увеличению скорости дрейфа неосновных носителей без изменения их количества. Такое положение будет сохраняться до величины обратного напряжения, при котором начинается интенсивный рост обратного тока – так называемый пробой p-n -перехода.

Слайд 272.3 Виды пробоев p-n-перехода .
Возможны обратимые и необратимые
пробои. Обратимый пробой – это пробой, после которого p-n-переход сохраняет
работоспособность. Необратимый пробой ведет к разрушению структуры полупроводника.
Существуют четыре типа пробоя: лавинный, туннельный, тепловой и поверхностный. Лавинный и туннельный пробои объединятся под названием – электрический пробой, который является обратимым. К необратимым относят тепловой и поверхностный.
2.3.1 Лавинный пробой.
Слайд 28Схема, иллюстрирующая лавинный пробой в p-n-переходе: а – распределение токов;
б – зонная диаграмма, иллюстрирующая лавинное умножение при обратном смещении
перехода
Слайд 29 Параметром, характеризующим лавинный пробой является коэффициент лавинного умножения
M, определяемый как количество актов лавинного умножения в области сильного
электрического поля.
,
Величина обратного тока после лавинного умножения будет равна:
,
где: I0 – начальный ток, U –приложенное напряжение, Uп -напряжение лавинного пробоя, n – коэффициент, равный 3 для Ge, 5 для Si.
2.3.2 Туннельный пробой.
Слайд 30Зонная диаграмма туннельного пробоя p-n -перехода при обратном смещении
ского пробоя
не превысит максимально допустимого значения, при котором произойдет перегрев и
разрушение кристаллической структуры полупроводника, то они являются обратимыми и могут быть воспроизведены многократно.
2.3.3 Тепловой пробой.
Тепловым называется пробой p-n -перехода, обусловленный ростом количества носителей заряда при повышении температуры кристалла. С увеличением обратного напряжения и тока возрастает тепловая мощность, выделяющаяся в p-n -переходе и, соответственно, температура кристаллической
Слайд 31структуры. Под действием тепла усиливаются колебания атомов кристалла, и ослабевает
связь валентных электронов с ними, возрастает вероятность перехода их в
зону проводимости и образования дополнительных пар носителей «электрон – дырка». Если электрическая мощность в
p-n -переходе превысит максимально допустимое значение, то процесс термогенерации лавинообразно нарастает, в кристалле происходит необратимая перестройка структуры и p-n -переход разрушается.
Для предотвращения теплового пробоя необходимо выполнение условия
где Pрасс max – максимально допустимая мощность рассеяния p-n-перехода.
2.3.4 Поверхностный пробой.
Распределение напряженности электрического поля в p-n -переходе может существенно изменить заряды, имеющиеся на поверхности полупроводника. Поверхностный заряд может привести к увеличению или уменьшению толщины перехода, в результате чего на поверхности перехода может наступить пробой при напряженности поля, меньшей той, которая необходима для возникновения пробоя в толще полупроводника. Это явление называют поверхностным пробоем. Большую роль при возникновении поверхностного пробоя играют диэлектрические свойства среды, граничащей с поверхностью полупроводника. Для снижения вероятности поверхностного пробоя применяют специальные защитные покрытия с высокой диэлектрической постоянной.
2.4 Емкость р-n-перехода.

Слайд 32 Изменение внешнего напряжения на p-n -переходе приводит к
изменению ширины обедненного слоя, и соответственно, накопленного в нем электрического
заряда (это также обусловлено изменением концентрации инжектированных носителей заряда вблизи перехода). Исходя их этого, p-n - переход ведет себя подобно конденсатору, емкость которого определяется как отношение изменения накопленного в p-n - переходе заряда к обусловившему это изменение приложенного внешнего напряжения. Различают барьерную (или зарядную) и диффузионную емкость p-n - перехода.
2.4.1 Барьерная емкость р-n-перехода.
Барьерная емкость соответствует обратно включенному p-n - переходу, который рассматривается как обычный конденсатор, где пластинами являются границы обедненного слоя, а сам обедненный слой служит несовершенным диэлектриком с увеличенными диэлектрическими потерями
где ε– относительная диэлектрическая проницаемость; ε0 – электрическая постоянная ;
S – площадь запирающего слоя; δ– толщина запирающего слоя.
Барьерная емкость возрастает при увеличении площади p-n - перехода и диэлектрической проницаемости полупроводника и уменьшении толщины запирающего слоя. В зависимости от площади перехода может быть от единиц до сотен пикофарад. Особенностью барьерной емкости является то, что она является нелинейной емкостью. При возрастании обратного напряжения толщина перехода увеличивается и емкость уменьшается. Под влиянием Uобр емкость С бар изменяется в несколько раз.

Слайд 33
2.4.2 Диффузионная емкость р-n-перехода.
Зависимость барьерной емкости от обратного напряжения
Диффузионная емкость характеризует накопление подвижных носителей заряда в n
- и p -областях при прямом напряжении на переходе. Она практически существует только при прямом напряжении, когда носители заряда диффундируют (инжектируют) в большом количестве через пониженный потенциальный барьер и, не успев рекомбинировать, накапливаются в n - и p -областях. Каждому значению прямого напряжения соответствуют определенные значения двух разноименных зарядов и, накопленных в n - и p -областях за счет диффузии носителей через переход. Диффузионная емкость представляет собой отношение зарядов к разности потенциалов:
Слайд 34 С увеличением Uпр прямой ток растет быстрее, чем
напряжение, т. к. вольт-амперная характери-стика для прямого тока имеет нелинейный
вид, поэтому Qдиф растет быстрее, чем Uпр и Сдиф увеличивается.
Диффузионная емкость значительно больше барьерной, но использовать ее не удается, т. к. она шунтируется малым прямым сопротивлением p-n - перехода. Численные оценки величины диффузионной емкости показывают, что ее значение составляет несколько единиц микрофарад.
Таким образом, p-n - переход можно использовать в качестве конденсатора переменной емкости, управляемого величиной и знаком приложенного напряжения.
2.5 Влияние температуры на ВАХ р-n-перехода.
Вольтамперные характеристики p-n -перехода для двух значений температуры
С ростом температуры падает прямое напряжение на p-n – переходе, при заданном токе и растет обратный ток при заданном напряжении.
Прямой ток p-n - перехода определяется потоком основных носителей заряда, который зависит от
Слайд 35величины потенциального барьера в p-n - переходе. Увеличение температуры приводит
к уменьшению потенциального барьера, а следовательно, к увеличению прямого тока.
Обратный ток p-n - перехода определяется потоком неосновных носителей заряда. Увеличение температуры приводит к увеличению скорости тепловой генерации, концентрация неосновных носителей заряда в полупроводнике растет, а следовательно, растет обратный ток.
Для количественной оценки влияния температуры на ВАХ p-n -перехода используют параметр.
Температурный коэффициент напряжения (ТКН) показывает, на сколько изменится прямое напряжение на p-n-переходе (ΔU) при заданном изменении температуры ΔТ при постоянном токе через p-n - переход:
Для германиевых p-n - переходов ТКН ≈-2 мВ/град, для кремниевых p-n - переходов ТКН ≈-3 мВ/град.
Температура удвоения обратного тока p-n - перехода Т* позволяет рассчитать обратный ток IОБР(Т0 + ΔТ) при возрастании температуры на ΔТ по известному значению обратного тока при заданной температуре Т0. IОБР(Т0 + ΔТ) = IОБР(Т0)·2ΔТ/Т . Для германиевых p-n - переходов обратный ток удваивается на каждые 10°C (Т* = 10°C) , для кремниевых - Т* = 8°C.
2.6 Равновесное и неравновесное состояние р-n-пере-хода.
Образование свободных носителей заряда в полупроводниках, образующих p-n – переход, связано с переходом электронов из валентной зоны в зону проводимости. Для осуществления такого перехода электрон должен получить энергию, достаточную для преодоления запрещенной зоны. Эту энергию электрон получает от ионов решетки, совершающих тепловые колебания. Таким образом, преодоление запрещенной зоны электроном происходит обычно за счет тепловой энергии решетки.

Слайд 36 Концентрация носителей заряда, вызванная термическим возбуждением в состоянии
теплового равновесия, называется равновесной.
Однако кроме теплового возбуждения появление
свободных носителей заряда может быть связано с другими причинами, например, в результате облучения фотонами или частицами большой энергии, ударной ионизации, введения носителей заряда в полупроводник из другого тела (инжекция) и др. Возникшие таким образом избыточные носители заряда называются неравновесными. Таким образом, полная концентрация носителей заряда равна:
n=n0+Δn,
p=p0+Δp.
где n0 и p0 - равновесная концентрация, а Δn и Δp - неравновесная концентрация электронов и дырок.
Если возбуждение избыточных электронов производилось из валентной зоны, а полупроводник однородный и не содержит объемного заряда, то концентрация избыточных электронов равна концентрации избыточных дырок:
Δn=Δp
После прекращения действия механизма, вызвавшего появление неравновесной концентрации носителей, происходит постепенное возвращение к равновесному состоянию. Процесс установления равновесия заключается в том, что каждый избыточный электрон при встрече с вакантным местом (дыркой) занимает его, в результате чего пара неравновесных носителей исчезает.
2.7 Контакт «металл – полупроводник».
В современных полупроводниковых приборах помимо контактов с p-n -переходом применяются контакты «металл – полупроводник».
Контакт «металл – полупроводник» возникает в месте соприкосновения полупроводникового кристалла n или р -типа проводимости с металлами. Происходящие при этом процессы определяются соотношением работ выхода электрона из металла Ам и из полупроводника Ап . Под работой выхода

Слайд 37электрона понимают энергию, необходимую для переноса электрона с уровня Ферми
на энергетический уровень свободного электрона. Чем меньше работа выхода, тем
больше электронов может выйти из данного тела.
В результате диффузии электронов и перераспределением зарядов нарушается электрическая нейтральность прилегающих к границе раздела областей, возникает контактное электрическое поле и контактная разность потенциалов
Переходный слой, в котором существует контактное электрическое поле при контакте «металл – полупроводник», называется переходом Шоттки. Контактное электрическое поле на переходе Шоттки сосредоточено практически в полупроводнике, так как концентрация носителей заряда в металле значительно больше концентрации носителей заряда в полупроводнике. Перераспределение электронов в металле происходит в очень тонком слое, сравнимом с межатомным расстоянием.
В зависимости от типа электропроводности полупроводника и соотношения работ выхода в кристалле может возникать обедненный, инверсный или обогащенный слой носителями электрических зарядов.
1. Ам<Аn, полупроводник n - типа(а). В данном случае будет преобладать выход электронов из металла в полупроводник, поэтому в слое полупроводника около границы раздела накапливаются основные носители (электроны), и этот слой становится обогащенным, т. е. имеющий повышенную концентрацию электронов. Сопротивление этого слоя будет малым при любой полярности приложенного напряжения, и, следовательно, такой переход не обладает выпрямляющими свойствами. Его иначе называют невыпрямляющим переходом.

случае будет преобладать выход электронов из полупроводника в металл, при
этом в приграничном слое также образуется область, обогащенная основными носителями заряда (дырками), имеющая малое сопротивление. Такой переход также не обладает выпрямляющим свойством.
3. Ам>Ап, полупроводник n - типа (а). При таких условиях электроны будут переходить главным образом из полупроводника в металл и в приграничном слое полупроводника образуется область, обедненная основными носителями заряда и имеющая большое сопротивление. Здесь создается сравнительно высокий потенциальный барьер, высота которого будет существенно зависеть от полярности приложенного напряжения. Если Ап>>Ам , то возможно образование инверсного слоя (p –типа). Такой контакт обладает выпрямляющим свойством.
Контакт «металл – полупроводник», не обладающий выпрямляющим свойством
Слайд 39Контакт «металл – полупроводник», обладающий выпрямляющим свойством
4. Ап>Ам , полупроводник
p - типа (б). Контакт образованный при таких условиях обладает
выпрямляющим свойством, как и предыдущий. Отличительной особенностью контакта «металл – полупроводник» является то, что в отличие от обычного p -n - перехода здесь высота потенциального барьера для электронов и дырок разная. В результате такие контакты могут быть при определенных условиях неинжектирующими, т. е. при протекании прямого тока через контакт в полупроводниковую область не будут инжектироваться неосновные носители, что очень важно для высокочастотных и импульсных полупроводниковых приборов.
Выводы:
1. p - n - переход образуется на границе p - и n - областей, созданных в монокристалле полупроводника.
2.В результате диффузии в p - n - переходе возникает электрическое поле – потенциальный барьер, препятствующий выравниванию концентраций основных носителей заряда в соседних областях.
3.При отсутствии внешнего напряжения в p - n - переходе устанавливается динамическое равновесие: диффузионный ток становится равным по величине дрейфовому току, образованному неосновными носителями заряда, в результате чего ток через p-n - переход становится равным нулю.
4.При прямом смещении p -n - перехода потенциальный барьер понижается и через переход протекает
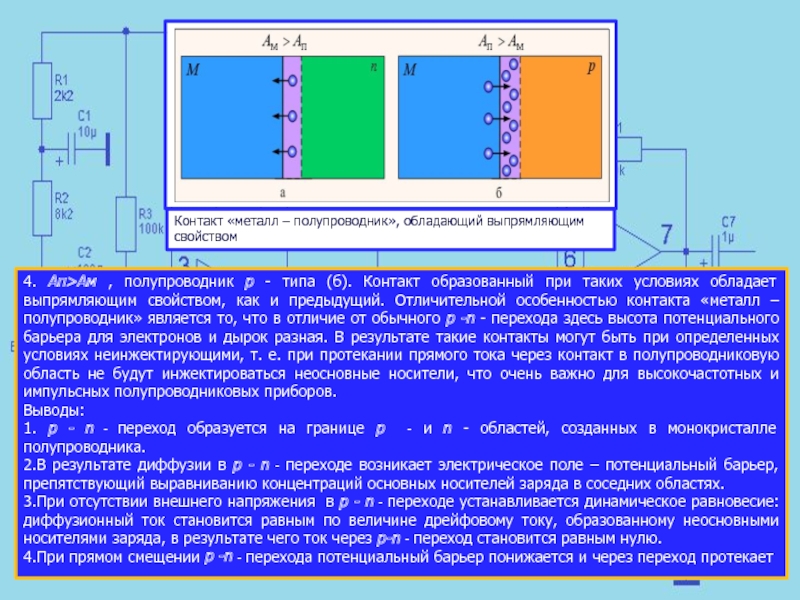
Слайд 40относительно большой диффузионный ток.
5.При обратном смещении p-n - перехода
потенциальный барьер повышается, диффузионный ток уменьшается до нуля и через
переход протекает малый по величине дрейфовый ток. Это говорит о том, что p-n - переход обладает односторонней проводимостью. Данное свойство широко используется для выпрямления переменных токов.
6.Ширина p-n - перехода зависит: от концентраций примеси в p - и n - областях, от знака и величины приложенного внешнего напряжения . При увеличении концентрации примесей ширина p-n – перехода уменьшается и наоборот. С увеличением прямого напряжения ширина p-n - перехода уменьшается. При увеличении обратного напряжения ширина p-n - перехода увеличивается. Это свойство позволяет использовать p-n – переход в качестве конденсатора.
7. Лавинный пробой p-n – перехода может использоваться для стабилизации напряжения.
8. p-n - переход обладает емкостными свойствами, но использовать можно только барьерную емкость, которая образуется при обратном смещении p-n – перехода.
9. Контакт «металл – полупроводник», при определенных условиях, тоже может обладать выпрямляющими свойствами.
3. Перспективы применения новых полупро-водниковых материалов.
3.1 Графен может быть полупроводником.
Чтобы графен стал полупроводником, необходимо обеспечить наличие запрещенной зоны. В последнее время можно отметить некоторые успехи в данной области. С помощью метода, использующего карбид кремния, создаются графеновые борозды размером в несколько нанометров. Благодаря волнистой форме графена удалось получить запрещенную зону в 0,5 эВ.

Слайд 41Структура графена как полупроводника
3.2 Молибденит как полупроводник.
Молибденит -
это давно известный минерал, полупроводник, широко распространённый по земному шару.
Он является основным промышленным сырьём для производства металлического молибдена. По своей химической природе он представляет собой соединение молибдена и серы с формулой M0S2. Цветом он похож на обычный металл - типа стали. У молибденита ширина запрещенной зоны составляет 1,8 эВ. Одним из преимуществ молибденита является то, что он двумерный и менее объемный чем кремний, который является трехмерным материалом. В листе молибденита толщиной 0,65 нанометра электроны могут перемещаться так же легко, как в листе кремния двухнанометровой толщины.
Слайд 42Молибденит - известный минерал, полупроводник