текстуры поверхности столь же давно, сколь и стилусные методы. Проводящая
пластина помещается над измеряемым проводящим образцом или (что встречается чаще) устанавливается на него[7]. Емкость между пластинами представляет собой функцию от эффективной площади пластин, расстояния между пластинами и диэлектрической постоянной находящейся между ними среды (обычно воздуха) [110]. Средняя емкость изменяется с изменением текстуры поверхности при перемещении верхней пластины над поверхностью. При использовании емкостных средств измерений для измерения текстуры поверхности причиной значительных затруднений может стать форма поверхности. Вследствие того, что емкость связана с инвертированной текстурой поверхности, высокие пики будут измерены иначе, чем долины.Отметим, что вышеописанная конфигурация обычно применяется для измерения дистанции (см. разд. 5.3). При использовании емкостных средств измерений текстуры поверхности возникает множество серьезных проблем; кроме того, их трудно калибровать. В настоящее время они используются редко и не имеют большого применения в микро- и нанотехнологиях. Впрочем, во многих областях микро- и нанотехнологий обширно используются сканируюшие емкостные микроскопы.
Федеральное государственное бюджетное образовательное
учреждение высшего образования
«Липецкий государственный технический университет»

![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова 6.8. Емкостные средства измеренийЕмкостные эффекты [108], [109] используются для измерения текстуры 6.8. Емкостные средства измеренийЕмкостные эффекты [108], [109] используются для измерения текстуры поверхности столь же давно, сколь и](/img/thumbs/bc60fe909b7463621678bcfebb9f58a1-800x.jpg)



![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова 6.10.2. Калибровка средств измерений параметров профиля поверхностиСтандарт ИСО 5436, часть 1 6.10.2. Калибровка средств измерений параметров профиля поверхностиСтандарт ИСО 5436, часть 1 [120] описывает пять типов эталонов, используемых](/img/thumbs/e461dfbc35bd1c78e24427858d91e9cd-800x.jpg)



















![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [12] Stedman M. Mapping the performance of surface-measuring instruments. Proc. SPIE. [12] Stedman M. Mapping the performance of surface-measuring instruments. Proc. SPIE. 83, 1987. P. 138—142.[13] Stedman M.](/img/tmb/3/297305/3420f8fe21df8d6cb27ab69c9560112b-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [25] ISO/FDIS 25178, part 6: Geometrical product specification (GPS). Surface texture: [25] ISO/FDIS 25178, part 6: Geometrical product specification (GPS). Surface texture: Areal. Classification of methods for measuring](/img/thumbs/e6a713fb36f366c179f628b3a0e74908-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [37] Hidaka K. , Saito A., Koga S., Schellekens P.H.J. Study [37] Hidaka K. , Saito A., Koga S., Schellekens P.H.J. Study ofa microroughness probe with ultrasonic sensor.](/img/thumbs/fc36ed8c7d3a87dca252280078468219-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [50] Proetner A., Schwider J. Dispersion error in white-light Linnik interferometers [50] Proetner A., Schwider J. Dispersion error in white-light Linnik interferometers and its implications for evaluation procedures.](/img/thumbs/e3e7dd6c928326357298594faf5a1328-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [64] Jordan H., Wegner M., Tiziani H. Highly accurate non-contact characterization [64] Jordan H., Wegner M., Tiziani H. Highly accurate non-contact characterization of engineering surfaces using confocal microscopy.](/img/tmb/3/297305/24406e4e517824dc1ba8957ec43cf183-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [78] Cuche E., Marquet P., Depeursinge C. Simultaneous amplitude-contrast and quantitative [78] Cuche E., Marquet P., Depeursinge C. Simultaneous amplitude-contrast and quantitative phase-contrast microscopy by numerical reconstruction of](/img/thumbs/3be0e0d14b7512064aa99b7a87aff794-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [88] Ghim Y.-S., You J. , Kim S.-W. Simultaneous measurement of [88] Ghim Y.-S., You J. , Kim S.-W. Simultaneous measurement of thin film thickness and refractive index](/img/thumbs/385ab20939a9a6b922f25f46512dbe37-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [101] ASTM F 1084—87: Standard test method for measuring the effect [101] ASTM F 1084—87: Standard test method for measuring the effect of surface roughness of optical components](/img/thumbs/4f77e1c18d7edf5d152b6bca1db2822b-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [112] Haitjema H. Uncertainty analysis of roughness standard calibration using stylus [112] Haitjema H. Uncertainty analysis of roughness standard calibration using stylus instruments. Precision Engineering. 22, 1998. P.](/img/thumbs/4d342f1a6b9d978502ea5e6bfdeebf58-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [124] Haycocks J., Jackson K., Leach R.K., Garratt J., MacDonnell 1., [124] Haycocks J., Jackson K., Leach R.K., Garratt J., MacDonnell 1., Rubert P., Lamb J., Wheeler S.](/img/thumbs/22973f7fcda9afd913266468b963977a-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова [136] Blunt L., Jiang X., Leach R.K., Harris P.M., scoff P. [136] Blunt L., Jiang X., Leach R.K., Harris P.M., scoff P. The development of user-friendly software measurement](/img/thumbs/aebf9ea47ee1f92c366566b336be9800-800x.jpg)









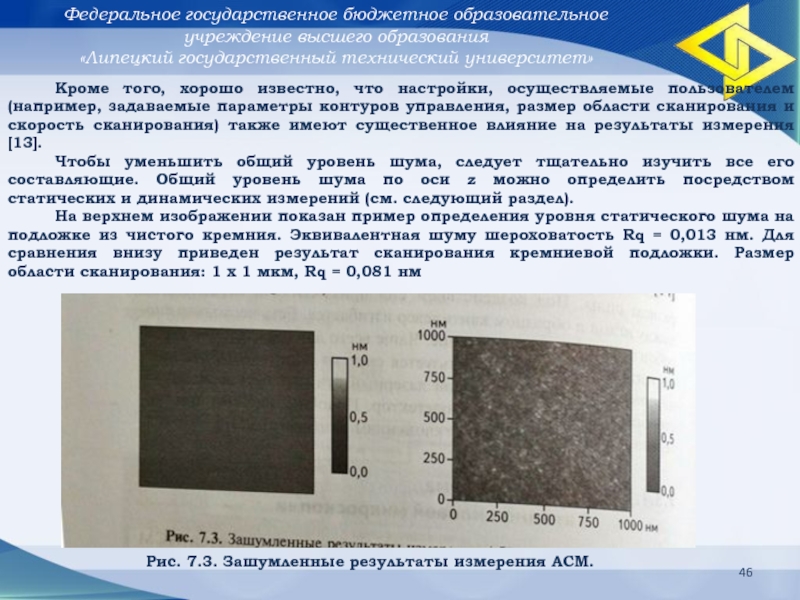






![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова 7.3.4. Прослеживаемость в атомно-силовой микроскопииС метрологической точки зрения АСМ делятся на 7.3.4. Прослеживаемость в атомно-силовой микроскопииС метрологической точки зрения АСМ делятся на три следующие категории [12]:• эталонные АСМ с](/img/tmb/3/297305/8a02491eb9c4e4ce0694d61cf514176e-800x.jpg)









![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова Вода вблизи гидрофильных поверхностей структурируется [34]. В случае с силовой микроскопией Вода вблизи гидрофильных поверхностей структурируется [34]. В случае с силовой микроскопией в растворе или влажной воздушной среде](/img/thumbs/7bc59c19c96133a345ce79b1e629251f-800x.jpg)
![Метрология, стандартизация и сертификация
Выполнила студентка ПТ-16
Кривчикова Вода вблизи гидрофильных поверхностей структурируется [34]. В случае с силовой микроскопией Вода вблизи гидрофильных поверхностей структурируется [34]. В случае с силовой микроскопией в растворе или влажной воздушной среде](/img/thumbs/622d01223d2c7e7acd64c2cf1f5a0f1f-800x.jpg)























