Слайд 1Методы атомно-силовой зондовой микроскопии
Слайд 2Межатомное взаимодействие
(силы Ван-дер-Ваальса)
Потенциал Леннарда Джонса
на больших расстояниях
зонд испытывает притяжение
со стороны образца
(дипольное взаимодействие)
бесконтактная АСМ
на малых расстояниях –
отталкивание
контактная
АСМ
Регистрация сил межатомного взаимодействия между концом зонда и поверхностью образца
Принцип действия АСМ
ULD(r) = –a/rm + b/rn
Слайд 3Принципы работы СЗМ
Система обратной связи (ОС)
контролирует расстояние между зондом
и образцом, используя параметр взаимодействия зонда и образца с взаимно
однозначной зависимостью от расстояния Р(z)
ОС поддерживает P постоянным P = P0,
изменяя напряжение
на z-сканере
Сигнал на Z-сканере
пропорционален
рельефу поверхности
Точность удержания
расстояния
зонд-поверхность
~ 0,01 Å
Слайд 4Принципы работы СЗМ
Формирование СЗМ изображения
сканирование в плоскости X,Y позволяет получить
СЗМ изображение поверхности
сканирующие элементы изготавливаются из пьезоэлектриков, которые изменяют свои
размеры во внешнем электрическом поле
Одновременно с рельефом можно получать распределения различных свойств поверхности
механических
электрических
магнитных
Слайд 5Принципы работы СЗМ
Исследование рельефа поверхности и ее локальных свойств проводится
с
помощью специальных зондов – игл с радиусом закругления ~
10 нм
Характерное расстояние между зондом и поверхностью ~ 0,1 ÷ 10 нм
Расстояние между зондом и образцом контролирует система обратной связи
Слайд 6Зондовые датчики АСМ
Зондовый датчик - упругий кантилевер (консоль) с острым
зондом на конце
сила, действующая на зонд со стороны поверхности, приводит
к изгибу кантилевера
регистрация величины изгиба D=– F/k закон Гука связывает изгиб кантилевера D, силу взаимодействия F и упругость кантилевера k
контроль силы взаимодействия зонда с поверхностью
Зонд и кантилевер изготавливается методами фотолитографии и травления
кантилевер формируется из
тонких слоев Si, SiO2 или Si3N4
один конец жестко
закреплен на
кремниевом держателе
на другом конце зонд
Слайд 7Геометрические параметры зонда
радиус закругления 1 ÷ 50 нм
угол при вершине
зонда 10 ÷ 20º
Резонансная частота кантилеверов
контактные 7÷28 кГц
бесконтакные 90÷630 кГц
Сила взаимодействия зонда
с поверхностью
F = k ⋅ ΔZ
ΔZ – характеризует изгиб кантилевера
k = 10-3÷10 Н/м коэффициент жесткости кантилевера
Проводящие покрытия для электрических измерений
Au, Pt, Cr, W, Mo, Ti, W2C
Ферромагнитные покрытия для магнитных измерений
Co, Fe, CoCr, FeCr, CoPt
Зондовые датчики АСМ
Слайд 8Типы АСМ кантилеверов
V-образный кантилевер
(контактная АСМ мода)
I-образный кантилевер
(бесконтактная АСМ мода)
Si3N4
Si
r
50 нм
F = 5 50 нН
k = 0.03
0.4 Н/м
f = 15 70 кГц
r < 20 нм
F ~ 1 пН
k = 25 100 Н/м
f = 160 420 кГц
Слайд 9Вид зонда в электронном микроскопе
Монокристаллический Si
Натуральный алмаз
PECVD Si3N4
Параметр Модуль Юнга
Плотность Микротвердость
(E) (ρg) (E/ρ) (GPa) (kg/m3)
Diamond 900–1050 3515 78.4–102
Si3N4 310 3180 19.6
Si 130–188 2330 9–10
Слайд 10Различные типы зондов
Вторично эмиссионное изображение зонда с использованием углеродной нанотрубки
Слайд 11Принцип действия АСМ
Оптическая регистрация изгиба кантилевера
лазер фокусируется на кантилевере
отраженный пучок
попадает в центр четырехсекционного фотодиода
Слайд 12Оптический силовой сенсор АСМ
Параметры, регистрируемые оптической системой
изгиб кантилевера под
действием
Z-компонент
сил притяжения
или отталкивания (Fz)
ΔIz=(ΔI1+ΔI2)−(ΔI3+ΔI4)
кручение кантилевера
под
действием
латеральных
компонент сил (FL)
ΔIL=(ΔI1+ΔI4)−(ΔI2+ΔI3)
Слайд 13Интерферометрические схемы контроля отклонения кантилевера
Интерференция возникает за счет разницы путей
света опорного и отраженного. Использование дополнительного модулятора позволяет повысить чувствительность
за счет синхронного детектирования
Слайд 14Система обратной связи АСМ
Система ОС
обеспечивает
ΔLz=const
Z-сканер
поддерживает
изгиб
кантилевера
ΔZ = ΔZ0,
задаваемый
оператором
Напряжение
на Z-сканере
пропорционально
рельефу поверхности
Слайд 15Роль обратной связи в АСМ
VS
Verr=V-VS
VC=VP+VI+VD
Пропорциональная компонента VP отвечает за отклик
на резкие изменения сигнала ошибки Verr
Интегральная компонента VI – низкочастотный
отклик: крупные детали рельефа, общий наклон
Дифференциальная компонента VD – стабилизация, гашение нежелательных осцилляций
Слайд 16Работа обратной связи АСМ
Изменение сигнала ошибки и напряжения на Z-сканере
при измерении ступеньки рельефа
Медленная ОС
Быстрая ОС
Слайд 17Контактные АСМ методики
Остриё зонда находится в непосредственном механическом взаимодействии с
поверхностью
Силы взаимодействия с образцом уравновешиваются силой упругости кантилевера
Метод постоянной
силы
Система ОС поддерживает
постоянной величину изгиба
кантилевера (Fz = const)
Напряжение на z-сканере
пропорционально рельефу
поверхности
Слайд 18Контактные АСМ методики
Метод постоянной высоты
Реализуется для образцов
с малыми перепадами
высоты
~ несколько Å
Отключенная ОС
Регистрация изгиба
кантилевера
ΔZ ~ Fz
Полученное изображение
характеризует
пространственное
распределение Fz
Слайд 19Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры АСМ изображений
30 мкм х
30 мкм
Аморфное
металлическое стекло
9 нм х 8 нм
Атомная решетка
MoTe2
Силовое изображение
(H=const
контактная мода)
Топография
(F=const контактная мода)
Слайд 20Метод постоянного рассогласования
Сигнал Рассогласования системы обратной связи, возникающий в процессе
сканирования с использованием Метода Постоянной Силы содержит дополнительную информацию относительно
рельефа поверхности. Он может быть использован для более полного воспроизведения рельефа.
Если скорость отработки сигнала рассогласования устанавливается такой, чтобы система была способна отрабатывать относительно гладкие особенности рельефа она не сможет отрабатывать крутые ступеньки. Сигнал рассогласования будет содержать данные о резких шероховатостях. Такой способ отображения может быть полезным для поиска небольших неоднородностей на большом относительно гладком фоне.
Слайд 21Микроскопия поперечных сил
Регистрация кручения
кантилевера под действием
латеральных компонент сил
различает
области с различными
коэффициентами трения
подчеркивает особенности
рельефа
возможно использование
одновременно с получением
рельефа поверхности
Слайд 22Микроскопия поперечных сил
Для малых отклонений угол закручивания пропорционален поперечной (латеральной)
силе. Торсионное закручивание кантилевера измеряется оптической следящей системой микроскопа.
При
сканировании поверхности с участками с различными коэффициентами трения угол скручивания меняется на каждом участке. Это позволяет проводить измерения локальной силы трения. Для того, чтобы различить участки с различными коэффициентами трения и неоднородности рельефа необходимо использовать второй проход в противоположном направлении.
Метод Латеральных Сил имеет важное значение при исследованиях полупроводников, полимеров, пленочных покрытий, запоминающих сред, при изучениях поверхностных загрязнений, химических особенностей и фрикционных характеристик, и т. д…
Слайд 23Микроскопия поперечных сил
Сегнетоэлектрические пленки PZT 30/70 +10 PbO
размер скана 5х5
мкм
Слайд 24Микроскопия поперечных сил
Гидратные пленки на основе Al
размер скана 8х8
мкм
Слайд 25Микроскопия модуляции сил
При сканировании на кантилевер подается переменная нагрузка
частота 5 кГц
амплитуда 2-20
Å
Регистрация амплитуды изгиба кантилевера
измерение пространственного распределения микротвердости
“мягкая”
поверхность
“твердая”
поверхность
Слайд 26Микроскопия модуляции сил
В процессе реализации Метода Модуляции Силы одновременно со
сканированием образца в соответствии с Методом Постоянной Силы сканер (или
образец) совершает вертикальные периодические колебания. При этом давление зонда на поверхность образца содержит периодическую (обычно синусоидальную) компоненту. В соответствии с локальной жесткостью образца амплитуда колебаний кантелевера будет изменяться в процессе сканирования. На жестких участках поверхности образца амплитуда будут меньше, а на мягких участках – больше
Отслеживание рельефа поверхности образца проводится с использованием усредненного изгиба кантилевера в системе обратной связи. При известной локальной жесткости можно определить модуль упругости образца.
Слайд 27Микроскопия модуляции сил
Полимерные пленки ПВХ
топография
микротвердость
Слайд 28Акустическая Микроскопия
Основная идея Атомно-силовой Акустической Микроскопии (АСАМ) заключается в возбуждении
колебаний находящегося в контакте с образцом атомно-силового кантилевера [1, 2].
Резонансные частоты кантилевера помимо других параметров, зависят от жесткости контакта зонд-образец и радиуса области контакта, которые в свою очередь зависят от модулей Юнга материалов образца и зонда, радиуса закругления кончика зонда, силы прижима зонда, рельефа поверхности. Этот метод позволяет определять модуль Юнга по контактной жесткости с разрешением несколько в десятков нанометров.
В процессе АСАМ измерений образец закреплен на пьезоэлектрическим преобразователе. Он возбуждает акустические колебания в образце, которые приводят к колебаниям поверхности. Колебания поверхности передаются кантилеверу через кончик зонда. Колебания кантилевера регистрируются с помощью четырехсекционного фотодетектора и подаются на синхронный усилитель. Соответствующее устройство может быть использовано для получения акустических изображений – карт распределения амплитуд колебаний кантилевера на фиксированной частоте колебаний вблизи резонанса (АСАМ отображение). АСАМ изображения отображают распределение поверхностной жесткости образца. Это устройство также может быть использовано для определения спектра колебаний кантилевера
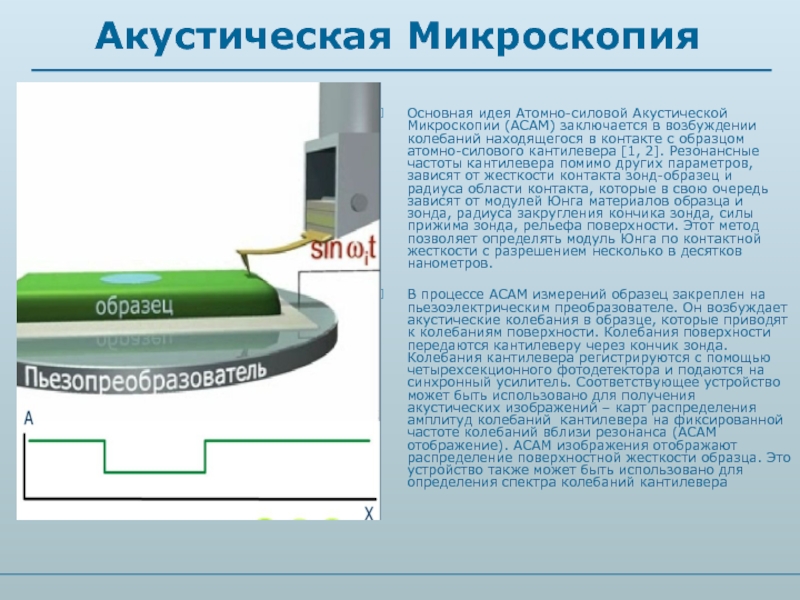
Слайд 29Колебательные АСМ методики
Полуконтактная
(tapping) АСМ
Бесконтактная
АСМ
Топография
Фазовый контраст
Слабая зависимость
силы от
расстояния
модуляционная техника
для повышения
чувствительности
Уменьшается механическое
воздействие зонда
на
поверхность
Открываются новые
возможности АСМ
по исследованию
свойств поверхности
Слайд 30Вынужденные колебания кантилевера
вблизи резонанса с амплитудой ~ 10 ÷ 100
нм
кантилевер касается поверхности
в нижнем полупериоде колебаний
амплитуда и фаза колебаний
кантилевера зависят от степени взаимодействия зонда с поверхностью
в нижней точке колебаний
Формирование изображения
регистрация изменений амплитуды и
фазы колебаний кантилевера
система ОС поддерживает постоянной амплитуду колебаний кантилевера
напряжение на z-сканере пропорционально рельефу поверхности
распределению фазового контраста соответствует изменение фазы колебаний кантилевера
Полуконтактная АСМ
Слайд 31Сравнение с контактной АСМ
Меньше риск повредить зонд
Меньшее влияние на поверхность
возможность
работы с «мягкими» образцами
Сильное влияние адсорбционного слоя
Полуконтактная мода
повышает разрешение
«протыкает» адсорбционный
слой
контактная АСМ
бесконтактная АСМ
Слайд 32Примеры АСМ изображений
Коллоидное золото
20 мкм х 20 мкм
Кристаллизация монослоя
оксида полиэтилена
14
мкм х 14 мкм
Топография
(полуконтактная АСМ)
Слайд 33Примеры АСМ изображений
5 мкм х 5 мкм
Трехфазная полимерная пленка (PMMA)
Топография Фазовый
контраст
Полуконтактная мода
Слайд 34Микроскопия магнитных сил
Зонд с ферромагнитным покрытием (Co)
Двухпроходная методика
1 проход рельеф поверхности
в полуконтактном режиме
2 проход зонд движется на высоте z0=const над образцом
по траектории, соответствующей рельефу
Изменение амплитуды или фазы колебаний кантилевера на 2ом проходе МСМ изображение
Слайд 35Микроскопия магнитных сил
MFM
nc-AFM
Изменение МСМ сигнала при удалении от поверхности (тестовый
образец)
Слайд 36Исследование наноматериалов методами сканирующей зондовой микроскопии
Качество МСМ изображения
Магнитостатическая сила зависит
от
доменной структуры на поверхности образца
толщины ферромагнитного покрытия
зонда
ориентации доменов в зонде
магнитных качеств зонда
Интерпретация результатов может усложняться в результате переориентации намагниченности
зонда под действием поверхности
поверхности под действием зонда
Выбор материала зонда с высоким коэрцитивным полем и большой магнитной анизотропией
Сканирование при достаточном расстоянии между зондом и поверхностью
Условия стабильности доменной структуры
Слайд 37Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры МСМ изображений
1.85 мкм х
1.85 мкм
Пермаллоевые капли
МСМ
бк-АСМ
Слайд 38Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры МСМ изображений
Магнитные биты
30 мкм
х 30 мкм
2.3 мкм х 2.3 мкм
Слайд 39Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры МСМ изображений
Магнитные частицы, покрытые
тонкой пленкой
9 мкм х 9 мкм
MFM
nc-AFM
Слайд 40Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры МСМ изображений
80 мкм х
80 мкм
Магнитные домены в сталях
10 мкм х 10 мкм
Слайд 41Электрические методики СЗМ
Слабое взаимодействие – модуляционная техника для повышения
чувствительности
механическая модуляция – переменное напряжение на пьезоприводе – механические колебания
кантилевера
электрическая модуляция – переменное напряжение на проводящем зонде
комбинированные методы
Двухпроходная методика
1 проход рельеф поверхности в полуконтактном режиме
2 проход зонд движется на высоте z0=const над образцом по траектории, соответствующей рельефу
изменение силы взаимодействия определяет электрические свойства
Исследование наноматериалов методами сканирующей зондовой микроскопии
Слайд 42Электрические методики СЗМ
Контактные электрические методики
сканирующая микроскопия сопротивления растекания
контактная сканирующая
емкостная микроскопия
силовая микроскопия пьезоэлектрического отклика
сканирующая микроскопия нелинейной диэлектрической проницаемости
Двухпроходные электрические
методики
электрическая силовая микроскопия
микроскопия поверхностного потенциала
(метод зонда Кельвина)
сканирующая емкостная микроскопия
Исследование наноматериалов методами сканирующей зондовой микроскопии
Слайд 43Электрические методики СЗМ
Основные принципы работы
Электростатическое взаимодействие между проводящим зондом
и заряженными областями вблизи поверхности образца
Исследование наноматериалов методами сканирующей зондовой
микроскопии
Слайд 44Микроскопия Пьезоотклика
Основная идея Силовой Микроскопии Пьезоотклика заключается в локальном воздействии
на пьезоэлектрический образец переменного электрического поля и анализе результирующих колебаний
его поверхности под зондом
Слайд 45Исследование наноматериалов методами сканирующей зондовой микроскопии
Силовая микроскопия пьезоотклика
Исследование доменной структуры
сегнетоэлектриков
Домены разных знаков отличаются знаком пьезо-коэффициентов
Поверхность над доменами разного знака
будет колебаться в противофазе
Фрактальная лабиринтовая исходная доменная структура германата свинца
Слайд 46Электрическая силовая микроскопия
Независимое измерение топографии
Механические
колебания
кантилевера на
резонансной частоте
при постоянной
разности потенциалов
Регистрация
локальных изменений резонансной частоты,
амплитуды или фазы
колебаний за счет электростатического взаимодействия
Исследование наноматериалов методами сканирующей зондовой микроскопии
Аморфные биты на DVD-RW диске
Топография
ЭСМ
5 х 5 мкм
Слайд 47Отображение Сопротивления Растекания
Отображение Сопротивления Растекания возможно при использовании проводящего зонда
ССМ, находящегося в контакте с поверхностью образца [1].
К
зонду прикладывается напряжение смещение и проводятся измерения результирующего тока через образец в зависимости от положения зонда одновременно с получением данных о рельефе по Методу Постоянной Силы.
Как легко показать в предположении постоянного контактного сопротивления зонд-поверхность при заданном смещении величина измеряемого тока пропорциональна локальному сопротивлению исследуемого образца.
Отображение Сопротивления Растекания может быть использовано и при анализе сложных структур, таких, например, как интегральные схемы.
Слайд 48Сканирующая микроскопия
сопротивления растекания
Контактная AFM мода
При сканировании прикладывается
разность потенциалов
Vdc и измеряется
ток в цепи I(x,y)
Строится распределение электрического сопротивления
R(x,y)=Vdc/I(x,y)
“Смешаны” топография и электрические свойства
Топография
СМСР
Слайд 49Электрическая силовая микроскопия
Исследование наноматериалов методами сканирующей зондовой микроскопии
Тестирование интегральных схем
(SRAM)
ЭСМ
Топография
Слайд 50Метод зонда Кельвина
Сила взаимодействия зонда с поверхностью приближенно описывается формулой:
где
Vtip – потенциал, создаваемый на зонде:
Отклик на первой гармонике:
Введение обратной
связи F1=0 позволяет измерять поверхностный потенциал Vsurf=Vdc
Исследование наноматериалов методами сканирующей зондовой микроскопии
Слайд 51Метод зонда Кельвина
Независимое измерение топографии
При измерении потенциала поверхности обратная
связь
осуществляется за счет изменения Vdc при условии F1=0
Строится изображение распределения
Vdc(x,y), соответствующее распределению поверхностного
потенциала Vsurf(x,y)
Исследование наноматериалов методами сканирующей зондовой микроскопии
В реальности подача переменного напряжения на зонд, в случае наличия потенциала на поверхности, приводит к возникновению дипольного взаимодействия и соответственно к механическим колебаниям кантелевера. В когда Vdc(x,y), равно Vsurf(x,y) дипольное взаимодействие минимально и колебания кантелевера минимальны. То есть подборов напряжения обусловлен выбором минимума колебаний.
Исследования распределения потенциала по поверхности может использоваться для исследования участков начального зарождения коррозии
Слайд 52Механическая разновидность зонда Кельвина
Для исследования коррозии
Зонд и образец образуют конденсатор.
В условиях существующей разницы потенциалов механические колебания зонда приводят к
изменению емкости конденсатора и протеканию тока. Величина тока зависит от разницы потенциалов. Подбирая потенциал в зонда каждой точке можно компенсировать потенциал поверхности, что приводит к исчезновению тока. Таким образом строится карта распределения потенциала по поверхности. В большинстве случав интересуются относительным изменением потенциала поверхности. Чтобы избежать нежелательного влияния поверхностного потенциала зонда используют материалы с постоянным поверхностным потенциалом, например зонд из протравленного Ni/Cr. Калибровка зонда выполняется измерением коррозионного потенциала с обычным референсным электродом который касается электролита покрывающего поверхность исследуемого образца.
Слайд 53Профиль высоты и потенциала измеренный с помощью зонда Кельвина на
поверхности железа с каплей водного раствора NaCl
Слайд 54Метод зонда Кельвина
Исследование наноматериалов методами сканирующей зондовой микроскопии
Электрический потенциал на
поверхности
двухкомпонентной пленки Ленгмюра-Блоджетта
Метод зонда Кельвина
6 х 6 мкм
Топография
Слайд 55Сканирующая емкостная микроскопия
Измерение производится аналогично методу зонда Кельвина
Измеряемая величина –
амплитуда сигнала второй гармоники:
Измерение емкости может проводиться непосредственно с помощью
моста. При F2w=const полезным сигналом будет сигнал рассогласования моста подаваемый в систему обратной связи
Исследование наноматериалов методами сканирующей зондовой микроскопии
Слайд 56Конденсатор MOS сформирован зондом SCM и полупроводниковым образцом
Слайд 57Зависимость
емкости и
дифференциальной емкости от напряжения DС для полупроводников
n-типа и p-типа.
Слайд 58Положительные и отрицательные заряды в изоляторе и полупроводнике вызывают параллельный
сдвиг в высокочастотной кривой C-V и dC/dV вдоль оси напряжений.
На рисунке показано, что положительные и отрицательные захваченные заряды вызывают сдвиг кривых C-V и dC/dV влево и вправо соответственно.
Слайд 59схема измерения dC/dV для полупроводникового образца p-типа. Переменное напряжение создает
вариацию емкости при фиксированном постоянном напряжении. Синхронный усилитель способен обнаружить
изменение амплитуды и фазы в сигнале емкости при одинаковой частоте переменного напряжения AC при заданном постоянном напряжении. Таким образом, выходной сигнал усилителя пропорционален наклону кривой С-V при заданном постоянном напряжении. Поэтому данный сигнал равен дифференциальной емкости (dC/dV). Микроскоп SCM обнаруживает дифференциальную емкость при фиксированном постоянном напряжении и переменном напряжении смещения в тот момент, когда зонд пересекает области с концентрацией носителей зарядов.
Слайд 60Схема зонда XE SCM с переменной рабочей частотой
Слайд 61Резонансные кривые разных материалов
Изменение емкости в паре «зонд-образец»
Слайд 62Сканирующая емкостная микроскопия
Измеряемая величина локальной емкости определяется
локальной диэлектрической проницаемостью
пространственным распределением
носителей заряда
толщиной диэлектрического слоя
геометрией поверхностей образца и зонда
Основное применение SCM
тестирование
полупроводниковых устройств
определение толщины оксидных поверхностных слоев
распределение примеси
Исследование наноматериалов методами сканирующей зондовой микроскопии
Слайд 63(a) Топография и (b) SCM изображение полупроводниковой поверхности. Яркая область
на топографическом изображении изображает серый силиконовый диоксид – слой высотой
70 нм. Яркие круглые и округлые прямоугольные области на рисунке SCM – это зоны сильного легирования ионами As+ энергией 50 кэВ и плотностью 1014 ионов/см2
Слайд 64изображения образца с имплантированными ионами Si
Слайд 65Сканирующая емкостная микроскопия
Исследование наноматериалов методами сканирующей зондовой микроскопии
Полевой транзистор
СЕМ
Топография
Слайд 66Сканирующая тепловая спектроскопия
Использование зависимости фотолюминисценции от температуры
Использование редкоземельных ионов в
качестве излучающих частиц Er3+, Yb3+, Eu3+
Использование Родамин В в качастве
излучающего тела
Зависимость интенсивности и частоты излучения CdSe/ZnS квантовых ям от температуры
Исследование наноматериалов методами сканирующей зондовой микроскопии
Зависимость относительной интенсивности фотолюминисценции родамина В от температуры
Зависимость фотолюменисценции PbF2 наночастиц допированных Er3+, Yb3+ от температуры –
А) спектры, б) отношение интенсивностей линий
Слайд 67Сканирующая тепловая спектроскопия
Исследование наноматериалов методами сканирующей зондовой микроскопии
Температурная зависимость спектра
излучения и интенсивности от температуры для квантовых точек в системе
CdSe/ZnS
Изображение вольфрамового зонда с приклееной на конце люминисцирующей наночастицей
Слайд 68Сканирующая тепловая спектроскопия
Исследование наноматериалов методами сканирующей зондовой микроскопии
Схема установки для
СТоМ
Лазер на 975 нм –возбуждает фотолюменисценцию. Регистрируются 2 длинны волны
раздельно 520 и 550 нм. Синхронный детектор выделяет частоту задаваемую колебаниями зонда.
Схема узла зонда. Амплитуда колебаний регистрируется фотодиодом по прерыванию лазерного луча. ОС поддерживает частоту колебаний =const
Слайд 69Сканирующая тепловая спектроскопия
Исследование наноматериалов методами сканирующей зондовой микроскопии
Пример получения распределения
температуры в образце с полоской поликристаллического кремния при протекании тока